KAIST-POSTECH 연구팀, 금속 뚫는 대신 쌓아서 연결
"다양한 반도체 집적회로 구현 연구에 핵심 역할 기대"
KAIST(총장 신성철)는 임성갑 생명화학공학과 교수와 김재준 POSTECH 교수 연구팀이 비아홀(via-hole, vertical interconnect access hole) 공정 없이 금속을 다중으로 상호 연결할 수 있는 기술을 개발했다고 11일 밝혔다.
연구팀은 반도체 절연막에 비아홀을 뚫는 기존 방식 대신 패턴이 새겨진 절연막을 쌓는 방식을 택했다. 패턴된 절연막은 패턴 구조에 따라 반도체소자를 선택적으로 연결한다.
연구팀은 '개시제를 이용한 화학 기상 증착법(iCVD: initiated chemical vapor deposition)'으로 얇고 균일한 절연막 패턴을 만들고, 이를 활용해 트랜지스터와 5층 이상 3차원 고성능 유기 집적회로를 구현했다. 또, 효과적인 금속 상호 연결을 위한 레이아웃 디자인 규칙을 제안했다.
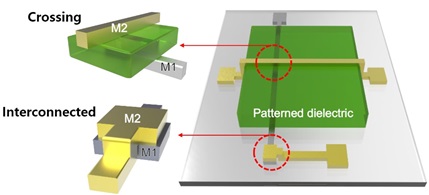
유기 트랜지스터는 전자 신호와 전력을 증폭할 때 사용되는 반도체소자로, 집적회로의 핵심 구성 요소다. 트랜지스터를 구부리거나 접어도 그 특성이 유지돼 유연(flexible) 디스플레이와 웨어러블 센서 등에 쓰인다. 그러나 유기물 반도체는 화학적 용매와 고온 등에 의해 쉽게 손상되기 때문에 일반적인 표면 가공이 적용되지 못한다.
연구팀은 패턴된 절연막을 쌓는 방법으로 유기물 손상 없이 100%에 가까운 소자 수율로 유기 트랜지스터를 제작했다. 수직적으로 분포된 트랜지스터들을 연결해 인버터(INVERTER), 낸드(NAND), 노어(NOR) 등 디지털 논리 회로도 만들었다.
김재준 교수는 "패턴된 절연막을 이용하는 발상의 전환이 유기 집적회로로 가기 위한 기술의 원천이 됐다"며 "유기 반도체뿐 아니라 다양한 반도체 집적회로 구현 연구에 핵심 역할을 할 것으로 기대된다"라고 말했다.
이번 연구 결과는 학술지 네이처 커뮤니케이션즈(Nature Communications) 6월 3일 자 온라인판에 게재됐다. 논문명은 'Highly stacked 3D organic integrated circuits with via-hole-less multilevel metal interconnects'다.
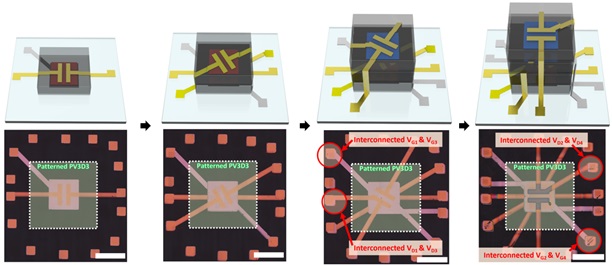
한효정 기자
hhj@HelloDD.com
댓글 정렬